在用于个人电脑和高性能服务器的尖端半导体开发方面,三维(3D)堆叠技术的重要性正在提高。在通过缩小电路线宽提高集成度的“微细化”速度放缓的背景下,3D技术将承担半导体持续提高性能的作用。台积电(TSMC)、英特尔等半导体大型企业以及日本的设备和材料厂商等正在竞相展开技术开发。
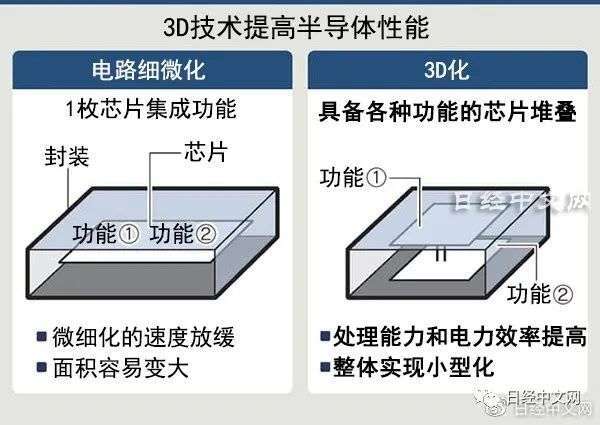
临时存储容量增至3倍
1月,美国超微半导体公司(AMD)在世界最大的电子产品消费展“CES”上推出的个人电脑CPU(中央处理器)受到半导体行业的关注,“我们非常兴奋能为大家提供配备3D技术的产品”。
特征在于其结构。通常是在相同硅基板上实现的运算和临时存储功能,但AMD的产品是由2枚不同的芯片分别承担功能,在1个封装内纵向叠加。这样一来,临时存储的容量提高到通常的3倍,游戏芯片的处理性能比此前产品提高了15%。AMD计划将3D技术应用于服务器CPU。
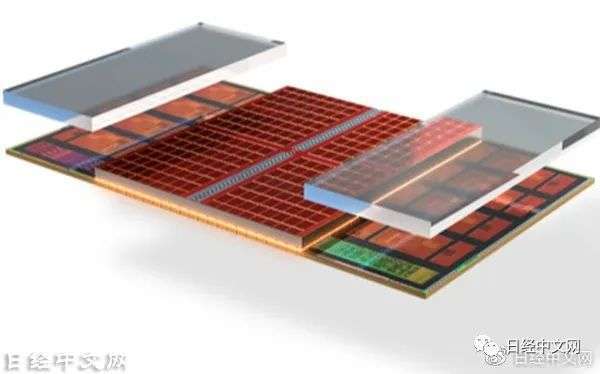
AMD在个人电脑CPU等产品上采用了3D技术
在过去约50年里,半导体性能提高的主角是在1个硅基板上嵌入大量微小电路的微细化。根据性能在18个月~2年内提高2倍的“摩尔定律”,微细化技术持续发展。英特尔1971年发布的首款CPU的元件数仅有约2300个,苹果最新发布的“M1”芯片元件数达到160亿个,增至约700万倍。但是,进入2010年代后,线宽接近原子的尺寸,微细化的速度开始放缓。
在此情况下,受到关注的是将多枚芯片纵向堆叠的3D以及横向排列连接的技术。通过不同的硅基板实现各种功能,像积木玩具一样组合起来,完全像1枚芯片在运行。可以不依赖微细化提高半导体的功能。
3月8日,苹果发布了个人电脑最高端芯片“M1 Ultra”,将横向排列的2枚芯片相互连接,配备了1140亿个元件。
根据用途可以组合出各种功能。人工智能(AI)半导体初创企业英国Graphcore于3月3日发布了采用3D技术的服务器芯片。将AI处理和电源供给的芯片堆叠,使之高效协作,与此前的AI半导体相比处理性能最多提高了40%,电力效率提高16%。
Graphcore放弃将微小芯片叠加起来的方法,而是采用了将2枚硅基板纵向堆叠之后切割为芯片尺寸的最新制造方式。首席技术官(CTO)西蒙·诺尔斯(Simon Knowles)表示通过这种方式,“实现了10倍的连接密度”。已在美国能源部的研究所被用于网络安全等研究。
从AMD、苹果和Graphcore承揽制造订单的是台积电。在微细化技术方面走在世界前列的台积电还将致力于3D半导体的技术开发。
散热等方面存在课题
台积电在茨城县筑波市设置后工序的研发据点,与日本设备和材料厂商展开合作,都是相关战略的一环。因为要制造不同于传统结构的3D半导体,日本企业具有优势的后工序技术日趋重要。
不仅是台积电。2021年12月,英特尔高管在东京举办的半导体展会上也呼吁其他企业:“通过合作加快实现发展蓝图”。
半导体设备制造商日本东和(TOWA)向比利时微电子研究中心(imec)提供封装设备,正在推进3D封装的联合开发。
要制造3D半导体,需要在制造设备和原材料领域出现新的技术创新。关键的重要零部件之一是用于多枚芯片连接的“转接板”。目前,存在如何提高连接速度、改善散热性和成本削减等课题。
市场规模达到6万亿日元
2021年11月,大日本印刷发布了被称为“RDL”的转接板新技术,量产效率超过了此前的硅制转接板。据介绍,在此前技术中难以实现的2微米线宽以下的布线变为可能。为了到2024年实现量产,12家日本企业组建的联盟正在推进开发。

在转接板上布线之际,要采用特殊的光刻设备,需要与通常光刻设备不同的特性,在尖端封装领域,佳能掌握着市场份额的大部分。从用于尖端封装的再布线层等的光刻胶来看,JSR和东京应化工业这2家日本企业掌握全球份额的6成以上。
法国调查公司Yole预测称,包括3D等技术在内的尖端半导体封装的2026年市场规模将增至2021年的1.5倍,达到519亿美元。随着技术创新,半导体领域将诞生新的火车头,相关市场也有望扩大。

标准化组织确保兼容性,推动新合作
半导体3D化的优点不仅限于持续提高性能。新形式的分工和合作或将取得进展。
尖端半导体的制造成本随着技术的升级,正在滚雪球般膨胀。如果采用多枚芯片分担功能的3D技术,“核心部分的芯片采用尖端进程,而周边部分采用非尖端技术,有可能降低制造成本”,行业相关人士表示。
将来,设想将不同公司设计和制造的芯片纳入相同的封装,作为1个产品使之发挥功能。英特尔、台积电和三星电子等半导体巨头于3月2日成立了芯片互连的标准化组织。谷歌、微软和Meta等美国IT企业也加入了组织。
索尼集团在主力的图像传感器上最先开始采用3D技术。有分析师指出,索尼在获取光像素和逻辑芯片的堆叠上采用铜的自主布线技术,“这是与(在熊本县合资建厂的)台积电合作上的关键技术”。
如果将各种芯片结合起来的3D技术得到普及,专注于设计的无厂半导体厂商之间、以及与后工序代工企业等的合作将提高重要性。以3D半导体的开发和制造技术为核心,半导体厂商的行业势力版图有可能发生改变。
日经中文网 https://cn.nikkei.com
本文来自微信公众号 “日经中文网”(ID:rijingzhongwenwang),作者:龙元秀明 佐藤雅哉
